分析・解析サービス
アシストナビの受託分析・解析評価サービスはものづくりを支える源!
評価設備の紹介
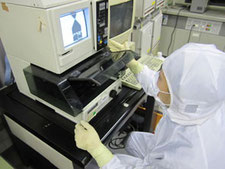

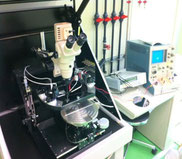
特色
- 御評価目的に合わせ技術スタッフが最適な分析方法プランをご提案します。
- ものづくり製造メーカーの観点から無駄を省き、現場の視点から問題解決を効果的にご支援します。
- お客様の低予算・短納期など仕様ニーズに合わせ柔軟な対応で専門スタッフが丁寧に対応します。
光干渉式膜厚測定装置
半導体プロセスにおける各種膜厚測定
測定対象: 膜SiO2(酸化シリコン)、Si3N4(窒化シリコン)、レジスト、ポリSi(ポリシリコン)、
ポリイミド/測定範囲10nm~20μm(膜種による)/測定再現精度0.1nm:膜厚10nm~3μm,0.03%:膜厚3μm~20μm/測定時間:約1秒

表面粗さ測定 『微細形状測定』
サンプルサイズ:600×100mm 縦方向分解能:0.08nm
測定長さ:0.08~8.0mm及び任意の長さ0.001mm毎

薄膜厚測定 『微細形状測定』
走査距離50μm-50mm/触針半径2.5μm/最大サンプル厚み45mm/
サンプリング時間1~50秒/触針圧1~40mgf

超深度形状測定顕微鏡(カラーレーザ顕微鏡)
3次元形状測定/膜厚測定
観察倍率50~16000倍/リアルカラー3次元表面解析機能/表面形状測定分解能0.01μm

微小硬さ試験機
マイクロビッカース硬さ試験
ビッカース圧子/試験荷重0.001~2kgf/くぼみ自動測定可

表面抵抗率測定
4端子4探針法により高精度な測定。
[Ω]、[Ω/□]、[Ωcm]、[S/cm]測定可

走査型オージェ電子分光分析装置
半導体表面微小部分析/金属多層薄膜深さ方向分析
電界放射型電子銃/同軸型円筒鏡エネルギー分析器/マルチチャンネルプレート検出器/分析モード:点分析、線分析、面分析、深さ方向分析

透過型電子顕微鏡(TEM)
反射電子線回折/透過電子顕微鏡観察/制限視野回折
倍率50~100万倍,加速電圧:200KV,写真現像タイプ,エネルギー分散型X線分光器付(炭素~ウラン)

走査電子顕微鏡(低真空対応SEM)
表面・内部観察機器
Wフィラメント型、加速電圧:1~30.0kV、分解能:3nm(加速電圧:30kV) 15nm(加速電圧:1kV)、ステージ80*40mm、低真空機能

X線CTスキャン装置
X線による断層撮影
直行及び斜めCT機能搭載/最大管電圧160KV/焦点寸法1μm(高詳細0.4μm)

X線応力測定装置
X線回折を利用した金属(結晶性)材料などの残留応力測定
Wフィラメント型、加速電圧:1~30.0kV、分解能:3nm(加速電圧:30kV) 15nm(加速電圧:1kV)、ステージ80*40mm、低真空機能

FIB-SIM (Scanning Ion Microscopy)観察
加速されたガリウム(Ga)イオンビームを集束させ、試料表面に走査することで発生する二次電子を検出して SIM(Scanning Ion Microscopy)画像として観測し、ナノメートル精度の高い位置精度で正確な断面加工がが可能です。また結晶粒の観察にも適しています。 画像確認をしながら作業できるため異物付着部や内部欠陥など特定の位置を見極めスピーディーに加工すること ができます。また、高分解能TEM,FE-SEM観察と組み合わせてより高度な観測が可能となります。